
設備:
Hamamatsu Themos-1000
特點:
- 2 in 1 設備:同時具備 OBIRCH+Thermal EMMI 雙功能,可直接切換後拍照,大幅提升分析效率,實現高效故障定位。
- Lock in 功能:有助於增強訊號提取的清晰度與準確性。
雷射光阻值變化偵測(OBIRCH)
技術原理:
利用雷射光束在 IC 表面掃描,造成掃瞄區域內的材料被加熱。當 IC 中存在缺陷時,局部熱傳導特性將異於完整區域,導致溫度變化並引起電阻值變化(ΔR)。如果在掃描同時對樣品施加定電壓,則可偵測到為電流變化關係為「 ΔI= (ΔR/R)I 」。並利用電腦以像素方式在掃描區域紀錄雷射加熱引發的電阻與電流變化,即可做出精確定位,如短路、開路及電阻異常等細微缺陷。
應用範圍:
- Silicon Base 操作
- 閘極氧化層漏電檢測
- 短路異常分析
- 金屬線缺陷/導通孔/接觸孔等阻值異常分析
案例分享:
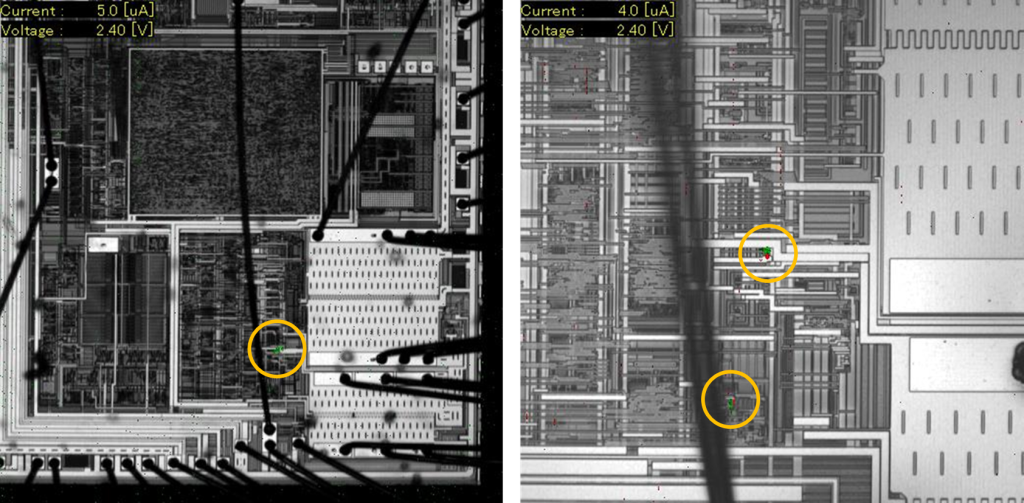
熱輻射故障定位顯微鏡(Thermal EMMI)
技術原理:
採用高靈敏度的 InSb 相機,在加電壓且利用 Lock in 的功能來偵測熱輻射的分佈,借此來精確定位失效位置。透過電流產生的紅外輻射,識別潛在問題(如短路或漏電)所產生的熱點與異常現象,並透過熱傳播特性所得到的相位圖(Phase)來估算Z軸的相關位置。
應用範圍:
- IC 封裝及內部短路分析
- 低阻抗區域分析( <10 ohm)
- 非破壞性檢測(IC 可不開蓋)
- PCB / 模組的金屬線路缺陷分析
- TFT-LCD 漏電 / 有機 EL 漏電定位
- 新制程開發階段 device 內部異常發熱的觀測